반도체/8대 공정
금속배선 공정
jun_code
2024. 11. 17. 00:35
금속배선 공정
정의와 특징
- 웨이퍼 위 트랜지스터들이 연결되어 동작할 수 있도록 하는 공정(반도체에 목적을 부여하는 공정)
- 산화 / 포토 / 엣치 / 증착 등의 공정을 통해 반도체 소자들이 웨이퍼 표면에 형성됨
- 웨이퍼 위 트랜지스터들이 동작하도록 소자와 외부 연결, 소자와 소자 연결이 필요하다
- Contact(도선과 소자 연결), 도선(소자와 소자 사이 전선), 베리어

Contact : 도선과 소자 연결
- 순서 : 하부의 소자층을 형성 -> 그 위에 컨택이라는 소자와 금속배선 연결부를 만듦 -> 그 위에 금속 배선을 연결
- Contact의 필요성
- 미세화로 인해 금속과 소자를 바로 연결하는 것이 불가능하다
- Al 등의 금속 물질은 타공이 깊은 경우 아무리 증착을 해도 틈이 잘 메워지지 않아 Gap Fill(빈틈을 채우는 특성)을 하더라도 중간이 빈 불량 도선이 되기 때문에 Contact이 필요하다
- 금속 배선 깊이가 깊을수록(소자층과 금속층이 먼 경우) W(텅스텐)과 같은 Gap Fill 특성이 좋은 금속으로 미리 채워두어야 한다 => W의 경우 열에도 강하기 떄문에 접점을 형성하고 그 위에 알루미늄 도선을 배치
- W : Gap Fill 특성이 좋다, 열에 강하다, 배선 저항이 크다(반도체 전력 소모 증가)
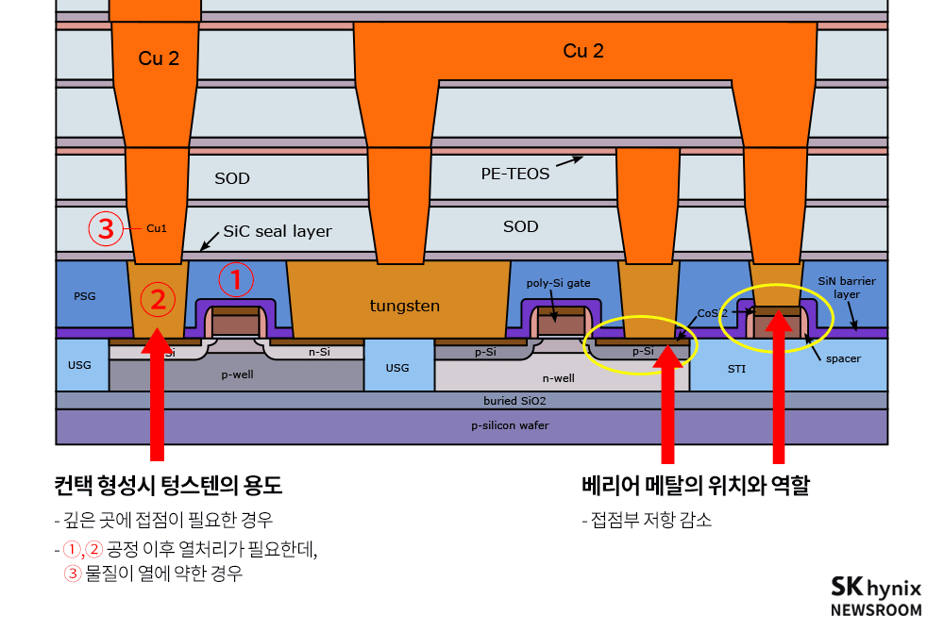
Barrier Metal : 금속간 저항 감소
- 소자와 접점 사이에 베리어 메탈이라는 금속을 통해 전력 소모를 줄이고 소자 손상을 방지한다
- 전력 소모 감소 : Silicidation(Contact Silicide를 만드는 과정으로 반도체 소자의 규소층(Si) 위에 Ti, Co와 같은 물질을 바르고 규소와 반응시킨다
- 특성이 다른 두 물질이 접하면 경계에서 큰 저항이 발생하여 전력 소모가 증가된다 => 경계면이 자연스럽게 비금속에서 금속으로 변하는 것처럼 만들기 위해 베리어 메탈을 사용한다
- 원치 않은 소자 손상 방지
- Al은 실리콘과 반응하려는 성질이 있어 Al 금속 배선과 규소층이 가까운 경우 Ti 화합물 등으로 차단한다

도선 : 소자와 소자 사이 전선
- 회로 위에 전선을 연결하는 과정으로 증착할 금속 종류에 따라 과정이 다르다
- 알루미늄 : 웨이퍼 표면에 금속 막 바르기 -> PR Coating -> Exposure -> 알루미늄 Etch -> 남은 Al 주변에 절연물질 채우기
- 구리 : 유전체를 먼저 증착하고 포토 후 식각